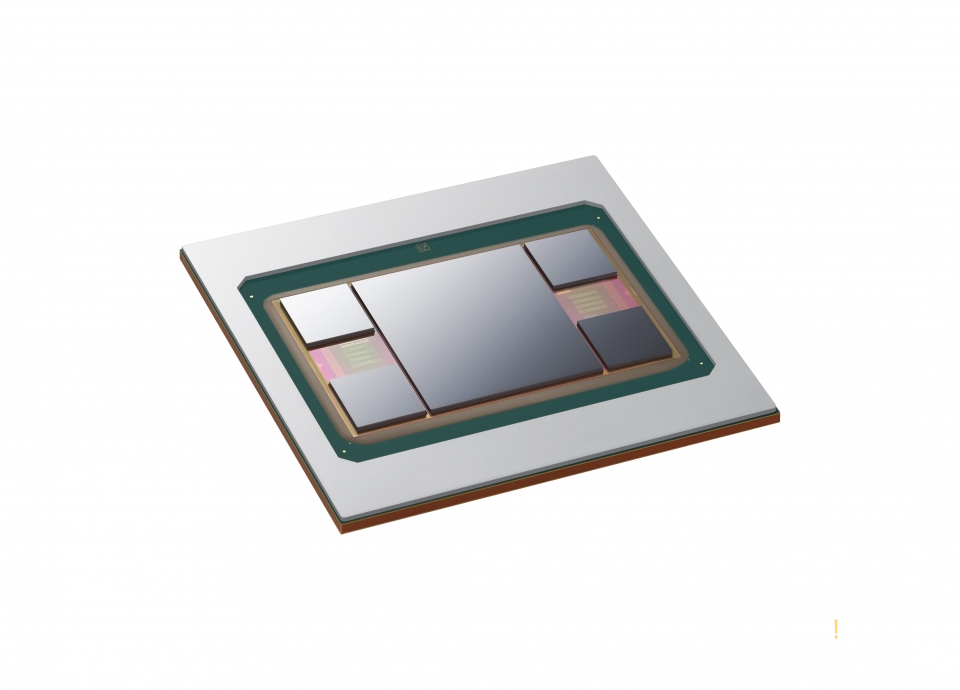
삼성전자는 로직 칩과 4개의 고대역폭 메모리(HBM) 칩을 하나의 패키지로 구현한 독자 구조의 2.5D 패키지 기술 I-Cube4를 개발했다고 6일 밝혔다.
I-Cube4는 고대역폭 데이터 전송과 고성능 시스템 반도체를 요구하는 고성능컴퓨팅(HPC)과 인공지능(AI), 클라우드 서비스, 데이터센터 등을 중심으로 폭넓게 활용될 것으로 기대된다.
삼성전자의 I-Cube는 기판과 IC칩을 연결하는 실리콘 인터포저 위에 중앙처리장치(CPU), 그래픽처리장치(GPU) 등 로직 칩과 HBM을 배치해 하나의 반도체처럼 작동하도록 하는 패키지 기술이다.
이를 통해 전송 속도는 높이면서 패키지 면적을 줄일 수 있다.
일반적으로 패키지 안에 실장하는 반도체 칩이 많아질수록 인터포저의 면적도 함께 증가해 공정상의 어려움도 커진다.
삼성전자는 100마이크로미터 수즌의 얇은 인터포저가 변형되지 않도록 재료, 두께 등 다양한 측면에 반도체 공정·제조 노하우를 적용했다.
I-Cube4에 몰드를 사용하지 않는 독자적인 구조를 적용해 열을 효율적으로 방출하도록 했다.
전체 공정 단계를 줄여 생산 기간을 단축했다고 회사는 설명했다.
강문수 삼성전자 파운드리사업부 마켓전략팀 전무는 "고성능 컴퓨팅 분야를 중심으로 차세대 패키지 기술의 중요성이 높아지고 있다"며 "차별화된 기술 경쟁력을 기반으로 HBM을 8개까지 탑재하는 신기술도 개발해 시장에 선보이겠다"고 말했다. ⓒ 세이프타임즈
관련기사
- 삼성 '커피에반하다' 스마트카페 쇼룸 1호점 '키오스크' 공급
- 삼성전자, 가정의 달 기념 '갤럭시 패밀리 페스타' 운영
- 삼성전자, 경기지역 유망 중기에 특허 73건 무상 양도
- 삼성 인공지능 로봇청소기 반려동물 배설물도 인식한다
- 삼성 시스템에어컨, 미국 냉동공조협회 '퍼포먼스 어워드'
- 삼성전자, 업그레이드 위치관리기 '스마트태그+' 출시
- 삼성전자 안전한 도로 주행 돕는 'PixCell LED' 출시
- 삼성전자, 케냐 난민촌 청소년 위해 '갤럭시탭' 1000대 기부
- 삼성 '업계 최초' 차세대 인터페이스 기반 D램 메모리 기술 개발
- 김윤선 삼성리서치 마스터 '한국인 최초' 3GPP 의장 선출
- 삼성 시스템반도체 171조원 투자 … 파운드리 공정 시설투자 가속
- 삼성전자 '비스포크' 무풍에어컨 라인업 확대
- 삼성전자, 스마트 모니터 M7 43형 출시 … 출고가 65만원
- 삼성전자, 무선청소기 신제품 '비스포크 슬림' 출시

